배터리 꾸준한 소형화 추세… 휴대전화 탑재 부품 39% 증가
스마트폰은 점차 소형화되고 다기능화되고 있다. 이는 휴대전화에 탑재되는 부품의 소형화를 유도하고 있다. 이와 관련, KAMP 국제 심포지움에서 LG전자 김현동 부장이 휴대전화에 적용되는 초고밀도 실장기술 동향에 대해 발표한 내용을 요약한다.

▲ 발표자 : LG전자 김현동 부장
스마트폰은 LTE 폰으로 발전하면서 점차 다기능화되고 있다. 휴대전화 내에 많은 기능을 구현하면서 탑재되는 칩 부품의 실장 수가 증가하고 있다. 2013년과 2014년의 휴대전화를 비교해 보면, LCD 사이즈는 6% 증가했고, 배터리 용량은 18% 증가했다. 부품 수는 930개에서 1280개로 38% 증가했다.
휴대전화 메인 보드는 그림 1와 같이 구성된다. Wifi 센서, AP, 메모리, 모뎀 등 다양한 부품이 탑재되며, 휴대전화의 다기능화에 따라 IC 계열의 부품이 점차 증가하고 있다.
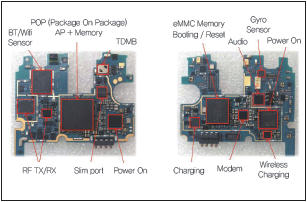
▲ 그림 1. 휴대전화 메인 보드 구성
디자인 측면에서 시장의 니즈는 배터리 용량을 확보하기 위해 부품 수는 늘리되 PCB 사이즈를 줄이는 것이라고 할 수 있다. 배터리 사이즈가 늘어나면 회로 Area가 줄어들어야 하기 때문이다. 이는 고밀도 실장기술의 개발을 반복적으로 순환하도록 한다.
고밀도 실장기술 적용 사례
1. PoP 3D 실장 기술
기존에는 Main Chipset과 Memory 3D를 따로 실장했다. PoP 3D 실장 기술에 따라 Memory 3D를 Main Chipset 위에 올리면 면적을 반으로 줄일 수 있다.
PoP 기술은 별개의 패키지를 각각 개별적으로 시험해 정상 패키지만 쌓을 수 있어 조립 과정의 수율을 높일 수 있어 휴대전화의 소형 모듈용으로 채택된다. 이러한 3차원적인 부품 배치를 통해 실장 면적이 줄어들고 배선 길이가 단축되는 것이다.
2. Filletless
Filletless는 소형 칩 자재의 솔더 Fillet을 삭제하는 것을 뜻한다. 솔더링되는 Fillet을 줄임으로써 실장 면적을 줄일 수 있는 것이다. 칩의 접합강도 및 장착 편차를 고려해 Fillet을 설계한다. PCB Pad 사이즈를 축소해 실장 면적을 약 20% 더 확보할 수 있다.
3. 0.35P BGA/Connector 부품 실장
2010년 가장 많은 비율을 차지한 것은 0.5P였다. 그러나 그 후 0.4P는 꾸준히 증가해 2014년 1위를 차지했다. 0.5P BGA는 그 수가 점차 줄었으며, 2014년부터 0.35P BGA가 증가하기 시작했다. 0.35P BGA는 0.4P BGA에 비해 면적을 32%나 개선할 수 있다.
4. Shadow 실장
Shadow 실장은 기존에 사용하지 않던 PCB Dead Zone을 활용하는 것이다. 이러한 영역을 활용해 일부 칩들을 실장할 수 있다. 예를 들어 칩을 10개 이상 실장해야 하는데 공간이 안 나온다거나 하는 경우에 활용할 수 있다. Shadow 실장은 불량이 발생했을 시, 재실장하는 것이 어렵기 때문에 사전에 Bending 테스트 등의 충분한 신뢰성 검사를 거쳐야 한다.
5. 0402 부품 실장
0402 부품은 세로 0.4mm, 가로 0.2mm의 부품으로, 스마트폰이나 웨어러블 기기 등 소형 모듈이 필요한 곳에 적합하다. 실장 부품의 소형화 추세에 따라 1005, 0603을 지나 0402로 진화하고 있다. 1005의 면적을 100이라고 할 때 0603은 그 면적이 36%이고, 0402는 16%에 불과해 면적을 84%나 줄일 수 있다.
소형 부품을 실장하기 위해서는 노즐을 각별히 관리해야 하며, Fee- der의 점검 주기를 강화해야 한다. 또한 솔더 프린팅 주요 공정도 관리할 필요가 있다.
고밀도 실장 기술을 위한 요구 사항
고밀도 실장으로 가면서 Void에 대한 요구는 점차 커지고 있다. 때문에 이러한 Void를 개선하기 위한 진공 Reflow의 필요성이 대두되고 있다.
또한 Mounter 장착 편차는 ±30㎛ 이내로, 인쇄 방식은 Dispensing 방식이 고려돼야 한다. PCB와 부품 Tolerance도 관리해야 하며, 다단 적층 부품 역시 지속적으로 증가할 것으로 전망된다.
정리 : 이솔이 기자





